臭氧前驱体用法:原理、用法与应用环节
臭氧前驱体则作为活性氧源参与薄膜生长,核心用于原子层沉积(ALD)等薄膜沉积环节
一、原理与用法
作为高活性氧源,在沉积过程中替代 H₂O、O₂等,提供无氢污染的氧原子,与金属前驱体发生自限性反应,确保薄膜均匀、致密、低缺陷。
典型场景为 ALD:与 TMA(三甲基铝)反应沉积 Al₂O₃,或与金属有机源生长高 k 介质(如 HfO₂)、氧化镓等。
二、应用环节
ALD 介电薄膜沉积:用于逻辑芯片 / 存储器件的栅极氧化物、高 k 介质层(如 Al₂O₃、ZrO₂),低温下实现高击穿电压、低漏电流与热稳定性。
光伏钝化膜制备:在 PECVD 氮化硅前,以臭氧前驱体辅助沉积超薄 SiOx,提升界面钝化与减反射效果。
MBE 外延生长:用于 β-Ga₂O₃等宽禁带半导体外延,在 600-850℃下调控生长速率与表面形貌。
薄膜改性活化:臭氧前驱体分解惰性膜表面基团,增加活性位点,加速 ALD 改性,提升亲水性与机械强度。
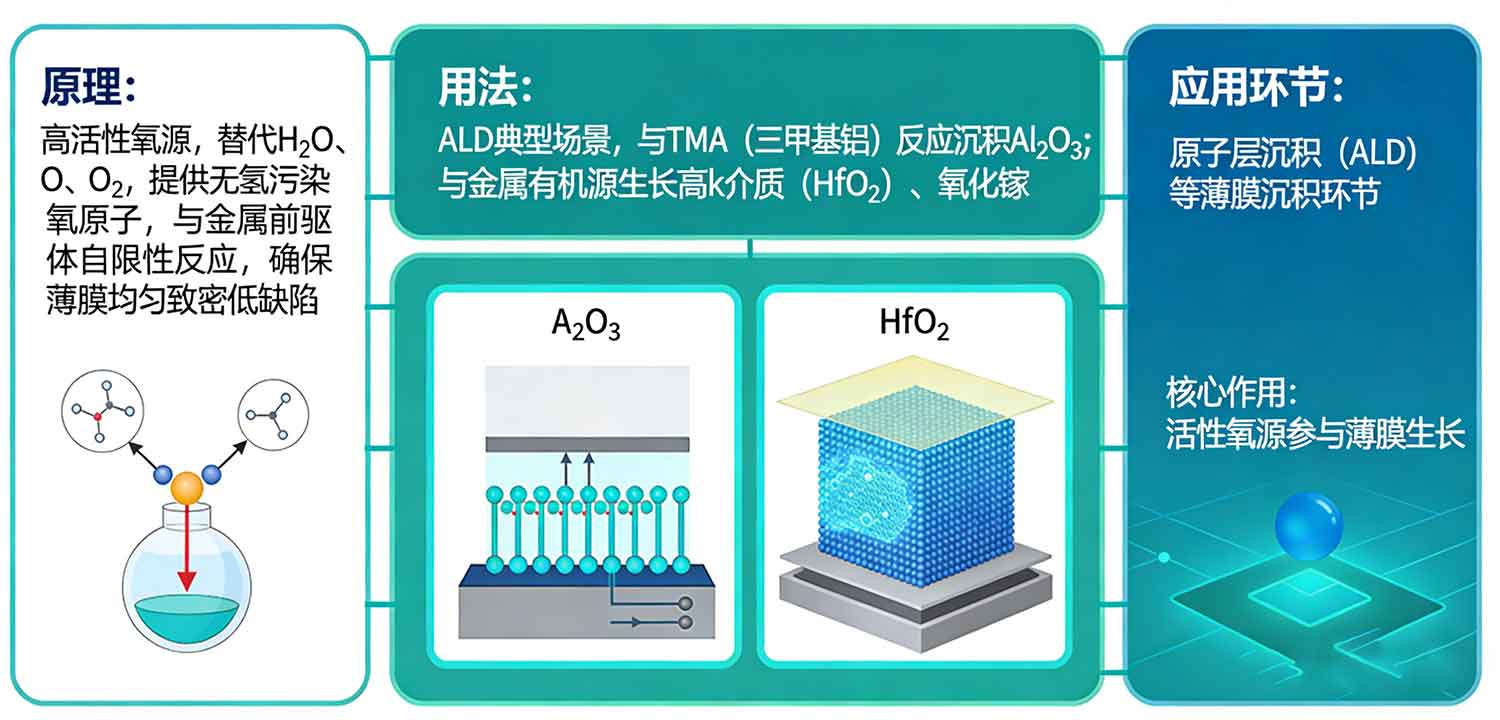
三、臭氧前驱体工艺的核心设备
1.原子层沉积(ALD)系统
结构:真空腔体、前驱体脉冲 /purge 系统、臭氧精确配送模块(含浓度 / 流量控制)、温度可控样品台、尾气处理。
适配工艺:前驱体与臭氧交替脉冲的自限性反应(如 TMA + 臭氧沉积 Al₂O₃),沉积温度 100-400℃,适合超薄、均匀的高 k 介质层 / 钝化膜。
典型应用:逻辑芯片栅极高 k 介质(HfO₂)、光伏 Al₂O₃钝化膜、功率器件栅氧化层沉积。
2.分子束外延(MBE)/ 脉冲激光沉积(PLD)外延设备
结构:超高真空腔体、臭氧源(可加热 / 脉冲控制)、分子束 / 激光源、衬底加热台。
适配工艺:宽禁带半导体(如 β-Ga₂O₃)外延生长,臭氧作为氧源调控薄膜化学计量比与表面形貌。
典型应用:电力电子器件用氧化镓外延层制备,透明导电氧化物薄膜生长。
3.等离子体增强原子层沉积(PEALD)设备
结构:ALD 基础上增加等离子体源,臭氧可与等离子体协同提供活性氧,降低沉积温度并提升薄膜质量。
适配工艺:低温沉积高致密性氧化物薄膜(如 Al₂O₃、ZrO₂),适合低热预算的先进制程。
典型应用:3D NAND 存储器件的阻挡层与隧穿层沉积。

四、北京同林臭氧源设备
3S-T10臭氧发生器,臭氧浓度10-120mg/L,10圈旋钮操作,臭氧产量10g/h
Atlas P30高浓度臭氧发生器,臭氧浓度10-220mg/L,触屏操作,臭氧产量30g/h
803N 高浓度臭氧发生器,臭氧浓度10-220mg/L,旋钮操作,臭氧产量8g/h
M1000高纯度臭氧发生器,臭氧浓度1-100mg/L,10圈旋钮操作,臭氧产量1g/h